2研究成果 / 高性能パワーデバイス
R-15
2021

電子線回折情報を用いたパワー半導体の高度欠陥構造解析

アピールポイント
高精度・3次元欠陥生成メカニズム詳細解析
【技術シーズ:透過電子顕微鏡TEM/電子線回折手法】
課題
・デバイス特性に悪影響を及ぼす結晶欠陥の種類や3次元的な形態の把握
・解析対象となる所望の結晶欠陥を正確に抽出・薄膜化する試料作製技術
・結晶欠陥の特徴や詳細な構造の理解(デバイス特性を左右する主要因の解明)
解決手段
・多光子顕微鏡、X線トポグラフィ、化学エッチング等との連携で欠陥形態を把握
・上記手法により特定した欠陥位置をもとに正確に集束イオンビーム(FIB)加工
・TEM法の一種である大角度収束電子線回折(LACBED)法により欠陥構造を解明
成果・優位性
・高い空間分解能での欠陥観察や3次元的な欠陥形態を把握
・他の安価・簡便な手法では識別困難な結晶欠陥の詳細な構造情報を取得
・半導体デバイスの製造履歴等と欠陥構造との相関から高性能化の知見を取得
・実験方法: 集束イオンビーム法、大角度収束電子線回折法
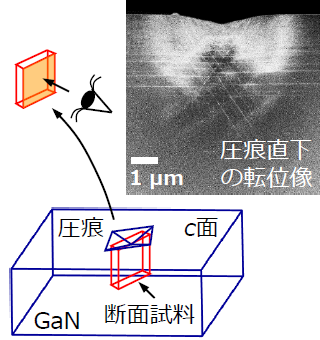
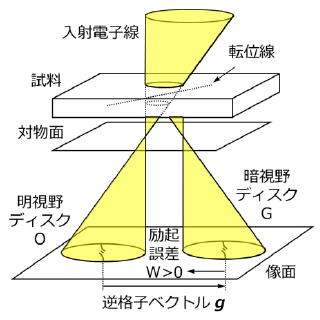

期待される市場・応用
・パワー半導体の欠陥低減につながるプロセス要因の洗い出し
・デバイス特性を更に向上させるための材料設計指針の提供
・欠陥構造の定量的な解釈によりその後の欠陥検出方法を簡素化
発表文献
Y. Ishikawa et al., Jpn. J. Appl. Phys., 59, 091005-1-091005-7 (2020).
謝 辞:本研究の一部は、知の拠点あいち重点研究プロジェクト、一部はJSPS科研費(20K05176)にて実施されたものである。
