6試験評価技術 / 微構造解析
T-34
2022

エッチピット法によるSiC結晶の欠陥解析評価技術

技術のポイント
ウェハ中の結晶欠陥情報を安価かつ多面的評価が可能パワーデバイスの信頼性向上に有用な情報を提供
保有技術
<エッチピット法>
溶融KOH+Na2O2を用いたエッチングによる欠陥検出法
特許第5519305号
<メリット>
SiC単結晶およびデバイスの結晶欠陥位置、種類、密度を正確に判別可能
従来評価手法で用いられているX線トポグラフィーと比較して、簡便かつ安価に評価可能
<適用可能なSiC単結晶>
p型-n++型SiC基板・エピ膜のSi面に適用可能
6インチまで適用可能
C面およびGaN、AlN、Ga2O3、ダイヤモンドについても対応可能(別途相談)
活用/成果例
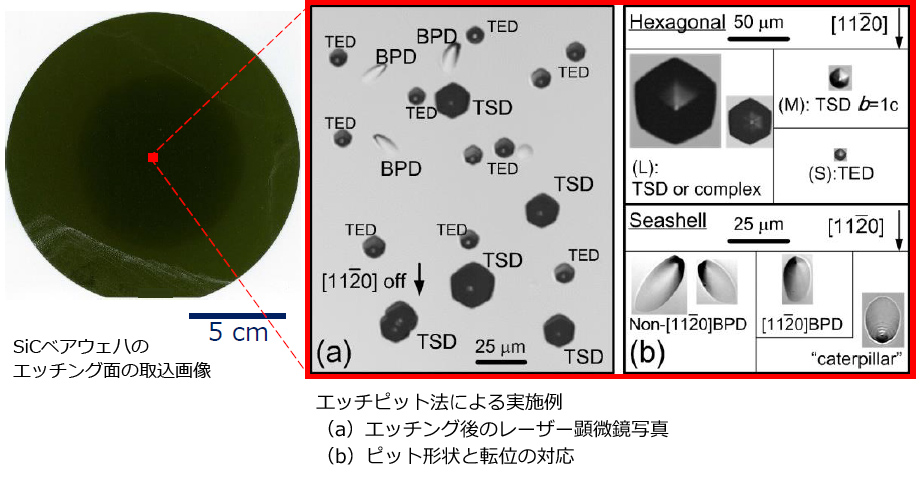
解析
・転位種毎の密度算出
・サイズからの転位の判別(統計処理)
・転位種毎の密度算出
・サイズからの転位の判別(統計処理)
Y. Ishikawa et. al, Mat. Sci.
Forum. Vols. 717-720 (2011).
適用分野
・SiCデバイスの開発:SiCウエハ、エピタキシャル膜品質評価、ウエハの品質保証、デバイス不良解析等
