5.結晶・形態解析
固体試料を対象として、X線回折および走査型電子顕微鏡による結晶・構造解析やエネルギー分散型X線分析による微小領域の組成分析を行います。
Testing & Evaluation Services
固体試料を対象として、X線回折および走査型電子顕微鏡による結晶・構造解析やエネルギー分散型X線分析による微小領域の組成分析を行います。
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| X線回折 (XRD) 45kV,40mA,1.8kW |
試料調製 | 1試料 | 10,000~ |
| 測定 | |||
| 常温測定 チャートのみ | 1測定 | 50,000~ | |
| データ解析(相同定) | 1データ | 25,000~ | |
| 残留応力測定(あおり角+方向のみ) | 1式 | 120,000~ | |
| データ解析(残留応力解析) | 1式 | 30,000~ | |
| その他データ解析 | -- | 別途相談 | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| X線回折 (高出力XRD) 50kV,300mA,18kW |
試料調製 | 1試料 | 10,000~ |
| 測定 | |||
| 常温測定 チャートのみ | 1測定 | 60,000 | |
| データ解析(相同定) | 1データ | 20,000 | |
| その他データ解析 | -- | 別途相談 | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| 高温X線回折 (高温XRD) 45 kV,40 mA,1.8 kW |
試料調製(粉砕) | 1試料 | 10,000~ |
| 測定 温度帯:~1200 ℃ 雰囲気:大気、真空、N2、Ar |
|||
| 高温測定(測定温度:~3点)(相同定含む) | 1式 | 160,000~ | |
| 追加測定 | 1測定 | 25,000 | |
| 追加分データ解析(相同定) | 1データ | 25,000 | |
| 高温残留応力測定(測定温度:~3点)(相同定含む) | 1式 | 250,000~ | |
| 測定温度帯追加測定 | 1式 | 25,000~ | |
| データ解析(残留応力解析) | 1測定 | 30,000~ | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| 高分解能 走査電子顕微鏡試験 (FE-SEM) |
試料調製 表面観察用 |
||
| 観察前準備(蒸着、試料台固定等) | 1試料 | 12,000~ | |
| 表面Arイオンミリング | 1領域 | 20,000~ | |
| 断面観察用 | |||
| 観察前準備(蒸着、試料台固定等) | 1試料 | 12,000~ | |
| 樹脂包埋 | 1試料 | 10,000~ | |
| 機械研磨 | 1試料 | 12,000~ | |
| 断面Arイオンミリング | 1領域 | 35,000~ | |
| FIB-SEM | 1領域 | 85,000~ | |
| その他特殊な処理を伴うとき | -- | 別途相談 | |
| 撮影 | |||
| 10万倍未満 | 1視野 | 50,000~ | |
| 1視野増すごと | 15,000 | ||
| 10万倍以上 | -- | 80,000~ | |
| 解析及び各種画像処理等 ※調製・観察に条件検討が必要な場合は別途相談 |
-- | 別途相談 | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| エネルギー分散型 X線分析試験 (FE-SEM-EDS) |
試料調製及び撮影 | 1試料 | FE-SEMに 準ずる |
| 組成分析(EDS)B(ボロン)~ | |||
| 定性分析 | 1点 | 35,000 | |
| 線又は面分析 | 1元素 | 35,000 | |
| 線又は面分析(追加元素) | 1元素増すごと | 25,000 | |
| 各種画像処理 | -- | 別途相談 | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| 後方散乱 電子回折試験 (FE-SEM-EBSD) |
試料調製及び撮影 | 1試料 | FE-SEMに 準ずる |
| EBSD測定 | |||
| 標準測定 | 1領域 | 200,000~ | |
| データ解析(IQ、IPF、CD、PF等) | 1データ | 200,000~ | |
| その他のデータ解析 | 別途相談 | ||
| wilkinson法による結晶歪解析用測定 | 1領域 | 400,000~ | |
| wilkinson法による結晶歪解析 | 1データ | 180,000~ | |
| 種別 | 項目 | 単位 | 単価(円) |
|---|---|---|---|
| FIB-SEM 3次元解析試験 (FIB-SEM-3D) |
試料調製(前処理) | 1試料 | FE-SEMに 準ずる |
| FIB加工条件検討 | 1領域 | 150,000~ | |
| SEM像スライス撮影(100枚) | 1式 | 300,000 | |
| 追加撮影(101枚~) | 100枚 | 200,000 | |
| 3次元構築 | 1式 | 別途相談 | |
| 各種データ解析 | 1式 | 別途相談 |
詳細料金表 1-1 | 1-2 | 1-3 | 1-4 | 2 | 3 | 4 | 5 | 6 | 7 | 8 | 9~10
細く絞った電子線を資料表面に照射し、そこから放出される電子線やX線などを検出することで、表面の凹凸、組成、結晶情報などを得ることが可能
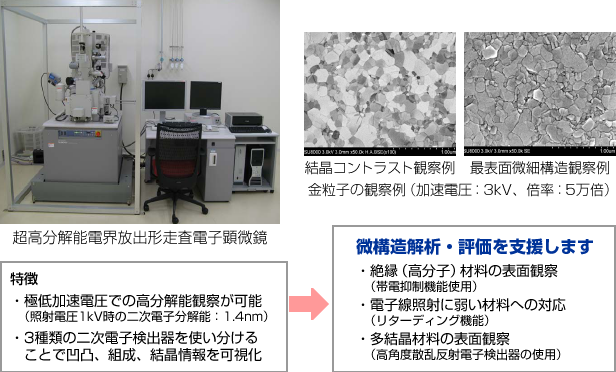
R-2 / R-6 / R-9 / R-10 / R-19 / R-22 / R-24 / R-28 / T-18 / T-34
動画の引用・無断転載・無断使用を固く禁じます。
詳細料金表 1-1 | 1-2 | 1-3 | 1-4 | 2 | 3 | 4 | 5 | 6 | 7 | 8 | 9~10