4研究成果 / 高性能パワーデバイス
R-19
2020
GaN/Siパワー半導体に形成される結晶欠陥のTEMによる構造解析
課題
優れた性能を有するパワー半導体の実現には、そのデバイス特性に強い影響を及ぼす結晶欠陥を分類・特定し、所望の領域から抽出した結晶欠陥の構造的な特徴との対応づけを可能にする技術群の確立・連携が必要不可欠である。
解決手段
・X線トポグラフィ(XRT)、化学エッチング法等により結晶欠陥を可視化、分類
・集束イオンビーム(FIB)法により所望の領域から結晶欠陥を正確に抽出
・大角度収束電子線回折(LACBED)法により結晶欠陥の詳細な構造情報を取得
成果・優位性
・XRTや化学エッチング法などとの連携により対象となる結晶欠陥を特定
・XRTやウィークビーム暗視野法との相補的な欠陥構造情報を取得
・LACBED法は未知の欠陥種に対しても高精度かつ正確な構造情報が取得可能
・結晶欠陥の詳細な構造情報をもとに、結晶形成時の欠陥形成機構を予測
・実験方法:放射光XRT、化学エッチング法、透過電子顕微鏡(明・暗視野法、LACBED法)
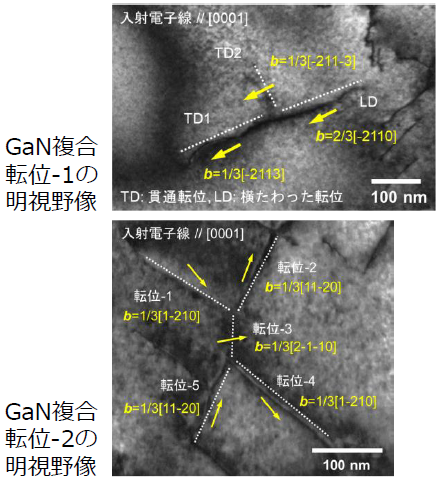
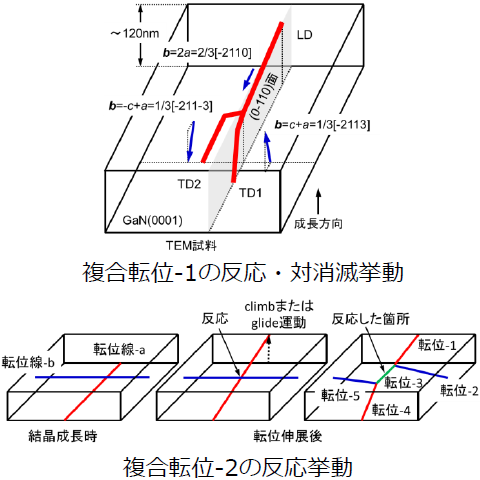
期待される市場・応用
・各種パワー半導体の材料開発における製造プロセス改善や不良解析への適用(SiC、GaN、AlN、ダイヤモンド等)
発表文献
Y. Sugawara et al., AIP Advances, 6, 045020-1-045020-7 (2016).
Y. Sugawara et al., J. Crystal Growth, 468, 536-540 (2017).
謝 辞:本研究の一部は、科学技術振興機構(JST)愛知地域スーパークラスタープログラムにて実施されたものである。
プレゼンテーション動画
R-2 / R-6 / R-9 / R-10 / R-19 / R-22 / R-24 / R-28 / T-18 / T-34
動画の引用・無断転載・無断使用を固く禁じます。
